
**번역본뉴스입니다. 오역이 있을수 있습니다.
NVIDIA가 현대 패키징 기술의 한계로 인해 자사의 가장 야심 찬 칩 개발 프로젝트 중 하나인 차세대 "Rubin Ultra" GPU 설계에서 제조 문제를 겪고 있는 것으로 알려졌습니다. 세계 최대 기업인 NVIDIA는 이미 표준 "Rubin" GPU의 고객용 샘플을 출하하고 있으며, 이번 여름부터 대량 출하를 시작할 예정입니다. 그러나 업그레이드된 "Rubin Ultra" 설계에 대한 현재의 로드맵은 기술적 한계에 부딪혔을 가능성이 제기되고 있는데, 이는 NVIDIA의 설계 목표가 TSMC의 패키징 역량에 비해 너무 야심 차기 때문입니다. 보도에 따르면, NVIDIA는 일반 "Rubin"의 2개 다이(Die) 패키지와 8개의 HBM4 모듈 구성을 두 배로 늘려, 단일 패키지에 4개의 실리콘 다이와 16개의 HBM4E 모듈을 포함하는 새로운 "Rubin Ultra" 패키지를 계획하고 있습니다. 이 구성은 2027년으로 예정되어 있으나, Global Semi Research에 따르면 실리콘의 엄청난 부피가 TSMC의 패키징에 너무 과도할 수 있다고 합니다.
전형적인 CoWoS 패키지에서 TSMC는 대개 여러 개의 작은 다이와 다수의 HBM 메모리 모듈을 결합하여 전체 AI 구축을 지원하는 통합 패키지를 만듭니다. 그러나 야심 찬 "Rubin Ultra" 설계를 위해 NVIDIA는 "Rubin Ultra"의 기반이 되는 설계와 개념을 처리할 수 있을 것으로 예상되었던 CoWoS-L을 사용할 계획이었습니다. 하지만 루머에 따르면, 이 아키텍처와 같이 4개의 다이를 의미하는 2+2 다이 패키지에서 TSMC는 워핑(Warping, 휘어짐) 문제에 직면해 있습니다. 기판을 포함한 패키지가 여러 방향으로 휘어지면서 "Rubin Ultra"의 연산 다이가 하단 기판과 완전히 접촉하지 못하게 되는 것입니다. 이러한 불안정성으로 인해 TSMC는 자사의 패키징 포트폴리오 내에서 대안을 모색해야 하는 상황입니다. 이러한 대안 중 하나는 CoPoS(Chip-on-Panel-on-Substrate)라고 불리는 패널화 방식입니다.
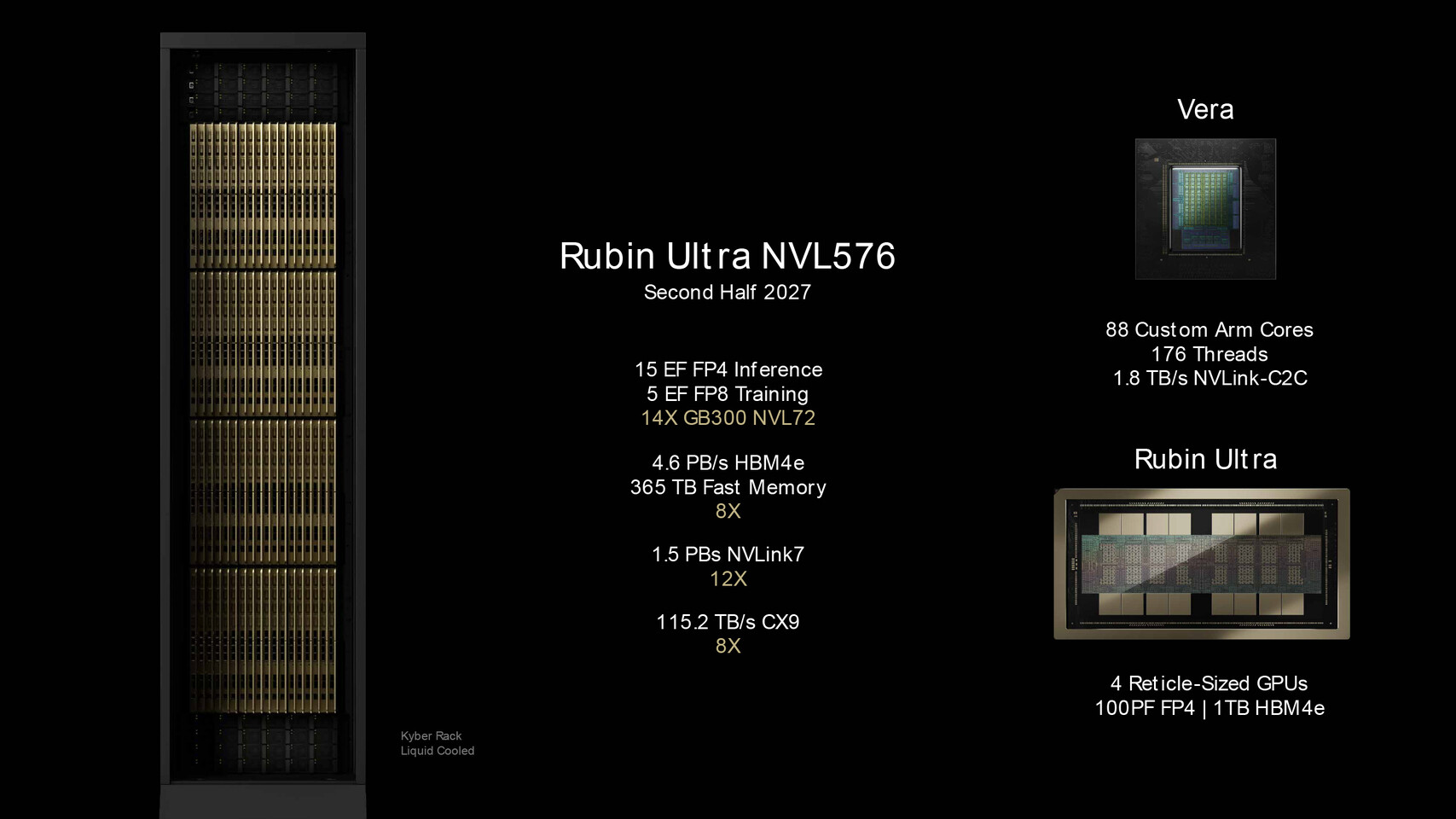
TSMC는 당초 이르면 2026년에 CoPoS 파일럿 라인을 구축하고 2028년 말에서 2029년 상반기 사이에 양산을 시작할 계획이었습니다. 이 변화는 약 300mm 크기의 실리콘 인터포저를 대형 정사각형 및 직사각형 패널로 교체하는 것을 포함합니다. 초기 포맷은 약 310 x 310 mm 크기이며, 이후 515 x 510 mm, 심지어 750 x 620 mm까지 확장될 예정입니다. 더 큰 정사각형 포맷은 낭비되는 가장자리 면적을 줄이고, AI 가속기를 위한 더 큰 레티클(Reticle)과 마스크를 수용하며, 단일 패키지에 더 많은 다이와 HBM을 배치하기 쉽게 설계되었습니다. 그러나 CoPoS가 2027년 데뷔에 맞춰 준비될 수 있을지, 아니면 TSMC가 CoWoS 문제를 먼저 해결해야 할지는 불확실합니다.
--------------------------------------------------------------------------------------광고(Advertising)--------------------------------------------------------------------------------------------------------



















